【10.2 离子注入】离子注入就是将纯净的具有一定能量的带电离子均匀地注入硅片的特定位置(这个特定位置一般由光阻或其他掩膜层来定义)的过程 。利用离子注入方法在半导体中搀杂是贝尔实验室的肖克利1954年的发明 。通过离子注入构成搀杂(N型或P型硅衬底中掺入P型杂质 硼、铟,或者掺入N型杂质磷、砷等),是制作半导体器件的基础 。
经过半个多世纪理论和实践的研究发展 , 离子注入技术和装备在半导体及超大范围集成电路制造业界已经非常成熟 。但是随着CMOS器件的关键尺寸缩小到45nm以下,轻搀杂源漏的PN结深已经小于20nm, 而且对深度散布的轮廓要求愈来愈陡,这就要求注入离子的能量要足够低 。如果以硼为标准换算,在45nm节点,PMOS轻搀杂源漏的离子注入能量要在1000eV乃至是几百个eV以下 。
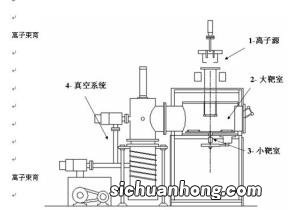
文章插图
如此低的能量,用传统的三氟化硼作为离子源根本没法调出稳定的束流来满足工业生产的要求,在这类情况下,半导体业界已经开始用大份子团诸如碳硼烷(,,,C2B10H12,B10H14 , B20H28,B18H22 )等取代传统的 BF2+ 、 B+ 进行离子注入 。
另外一方面 , 为了得到低阻值的超浅结 , 源漏极(SD)及源漏扩大结构(SDE)离子注入的能量在降低 , 而剂量却基本保持不变乃至有所增加 , 同时在注入离子活化方面,也引入了毫秒级的高温退火工艺 。这使得器件对离子注入的缺点控制很敏感,比如说离子注入引发的硅表面损伤和射程端缺点将大大增加源漏端的漏电流 , 在后续的镍硅化物构成过程当中可能构成管道缺点 。近年来,离子注入缺点控制的研究和应用也愈来愈深入和成熟,比如说低温离子注入和为了降低离子活化过程当中瞬时增强分散而额外的共同离子注入(如C、F、 N) 。下面就对这几种比较新的离子注入工艺作简单介绍 。
关于本次10.2 离子注入的问题分享到这里就结束了 , 如果解决了您的问题,我们非常高兴 。
猜你喜欢
- 高通被“反超”了?
- 中方用实力说话,芯片有重大突破
- “光子芯片” 发展时间表
- 天才少年,大展身手
- 美调查华为芯片,结果出人意料,反成笑话
- 媒体与公众反应
- 先进工艺制程接二连三,台积电宣布1nm
- 华为麒麟9000
- 高端芯片和成熟芯片需求怎么?
